半導体産業における応用
GREENは、自動化された電子機器組立、半導体パッケージング・試験装置の研究開発と製造に特化した国家ハイテク企業です。BYD、Foxconn、TDK、SMIC、Canadian Solar、Mideaといった業界リーダーをはじめ、20社を超えるFortune Global 500企業にサービスを提供しています。高度な製造ソリューションを提供する信頼できるパートナーです。
ボンディングマシンは、ワイヤ径の微細化による微細配線を可能にし、信号品質を確保します。ギ酸真空はんだ付けは、酸素含有量10ppm未満の環境下で信頼性の高い接合部を形成し、高密度実装における酸化不良を防止します。AOIはミクロンレベルの欠陥を検出します。これらの相乗効果により、99.95%を超える高度なパッケージング歩留まりが保証され、5G/AIチップの厳しいテスト要件を満たします。

超音波ワイヤーボンダー
100 μm~500 μmのアルミ線、200 μm~500 μmの銅線、最大幅2000 μm、厚さ300 μmのアルミリボン、銅リボンの接合が可能です。
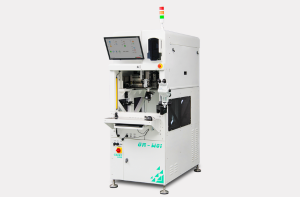
移動範囲: 300 mm × 300 mm、300 mm × 800 mm (カスタマイズ可能)、再現性 < ±3 μm

移動範囲:100 mm × 100 mm、再現性:±3 μm未満
ワイヤーボンディング技術とは?
ワイヤボンディングは、半導体デバイスをパッケージまたは基板に接続するために用いられるマイクロエレクトロニクス相互接続技術です。半導体業界において最も重要な技術の一つであり、電子機器内のチップと外部回路とのインターフェースを可能にします。
ボンディングワイヤ材料
1. アルミニウム(Al)
金よりも優れた導電性、コスト効率に優れています
2. 銅(Cu)
Auより25%高い電気/熱伝導率
3. 金(Au)
最適な導電性、耐腐食性、接合信頼性
4. 銀(Ag)
金属の中で最も高い導電性
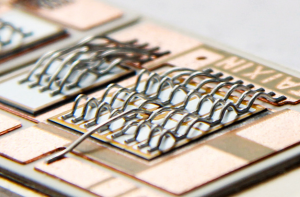
アルミ線

アルミリボン

銅線

銅リボン
半導体ダイボンディングおよびワイヤボンディングAOI
25メガピクセルの産業用カメラを使用して、IC、IGBT、MOSFET、リードフレームなどの製品のダイアタッチおよびワイヤボンディングの欠陥を検出し、99.9%を超える欠陥検出率を実現します。

検査事例
チップの高さや平坦度、チップのオフセット、傾き、欠け、はんだボールの非接着とはんだ接合部の剥離、ループ高さの過剰または不足、ループの崩壊、ワイヤの断線、ワイヤの欠落、ワイヤの接触、ワイヤの曲がり、ループの交差、テール長の過剰などのワイヤボンディング欠陥、接着剤の不足、金属の飛び散りを検査できます。
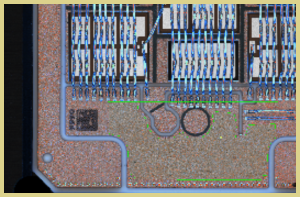
はんだボール/残留物

チップスクラッチ

チップ配置、寸法、傾斜測定
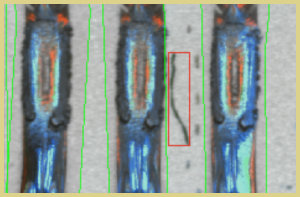
チップ汚染/異物
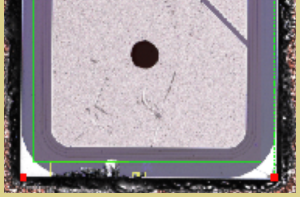
チップチッピング
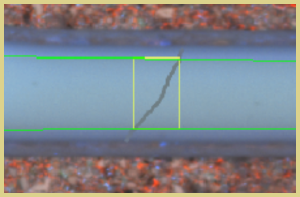
セラミックトレンチクラック

セラミックトレンチの汚染
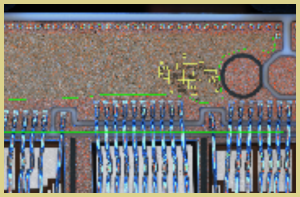
AMB酸化
インラインギ酸リフロー炉

1. 最高温度 ≥ 450°C、最低真空レベル < 5 Pa
2. ギ酸および窒素処理環境をサポート
3. 単一点ボイド率≦1%、全体ボイド率≦2%
4.水冷+窒素冷却、水冷システムと接触冷却を装備
IGBTパワー半導体
IGBTのはんだ付けにおいて、ボイド率が高すぎると、熱暴走、機械的クラック、電気性能の低下といった連鎖反応による故障を引き起こす可能性があります。ボイド率を1%以下に低減することで、デバイスの信頼性とエネルギー効率が大幅に向上します。
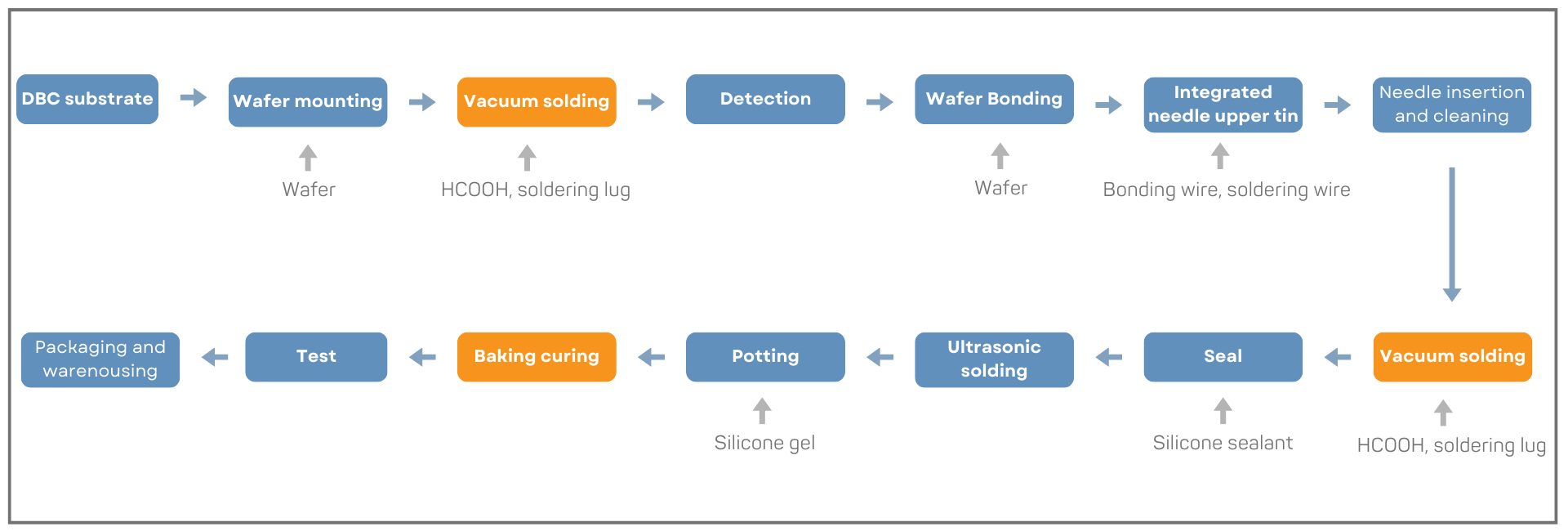
IGBT製造プロセスフローチャート








